正电子谱学原理
n
正电子
n
正电子湮没

n
双光子湮没
n = 2
n
正电子寿命
n
湮没光子的能量和Doppler展宽
n
湮没光子的角关联
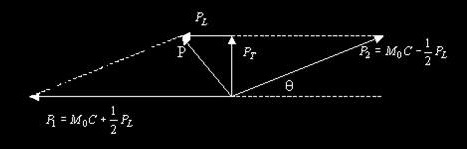
2g湮灭过程中动量守恒的矢量图



Doppler展宽的线性参数
n
正电子源
=
放射性同位素

=
单能慢正电子束
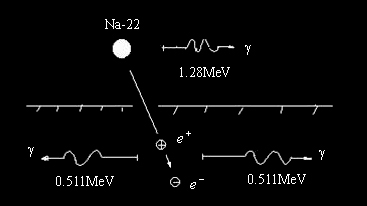
正电子实验
n
正电子湮没技术(70年代)
n
正电子湮没谱学(80年代)
n
正电子谱学(90年代后期)
n
正电子谱学的主要特点:
=
对固体中原子尺度的缺陷研究和微结构变化十分敏感,是其他手段无法比拟的。
=
对研究材料完全无损伤,可进行生产过程中的实时测量,能够满足某些特点的测量要求。
=
理论比较完善,可以精确计算很多观测量同实验进行比较。
=
固体内部的信息由光子毫无失真的带出,对样品要求低,不需特别制备或处理,不受半导体导电类型和载流子浓度等因素影响。
=
作为电子的反粒子,正电子容易鉴别,又能形成电子偶素,可以替代电子探针来获得材料中更多的信息,在许多实验中能够大大降低电子本底。
正电子谱学基本实验技术
n
正电子寿命谱
n
湮灭能谱的Doppler展宽及其S参数
n
湮没辐射的角关联
n
慢正电子束
=
慢正电子束装置
=
单能正电子的注入深度
=
正电子扩散

慢正电子束流的慢化体结构

其中,S: 22Na源 P: 铅屏蔽 M: 钨慢化体 T: 靶材料
C: 有补偿线圈
D: 高纯锗探测器 E: 液氮冷却装置
Slowpos-USTC:慢电子束流装置示意图
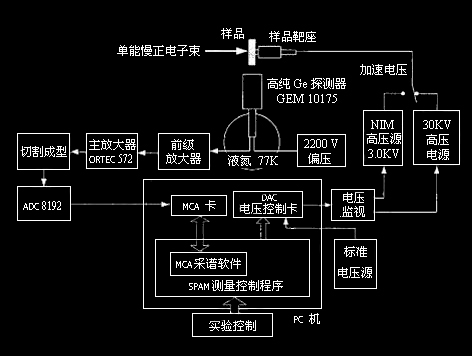
Slowpos-USTC:慢电子束的数据测量和控制系统
=
慢正电子束特点:
u
可探测真实表面(几个原子层)的物理化学信息
u
探测物体内部局域电子密度及动量分布
u
可获得缺陷沿样品深度的分布
n
单能正电子平均注入深度的经验公式:

正电子谱学应用之一
Open volume defects of
superconducting thin film YBa2Cu3O7-d
高温超导体中空位型缺陷不仅是不可避免的,而且也是必须的。
外延薄膜的临界电流密度比相应的块材单晶高约三个量级。
单能慢正电子束是研究薄膜空位型缺陷的有效方法。
n
Open volume defects of superconducting thin film YBa2Cu3O7-d
=
空位型缺陷与沉积条件的关系
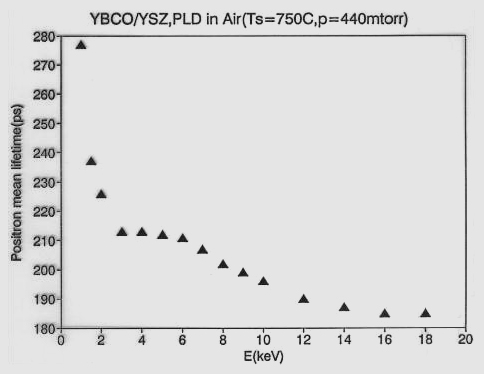
X Y Zhou et al ,
J Phys. CM 9, L61
Phys.Rev. B54, 1398
Phys.Lett. A225, 143
Physica C
281, 335
=
相同空气分压,衬底温度越高,正电子平均寿命越小
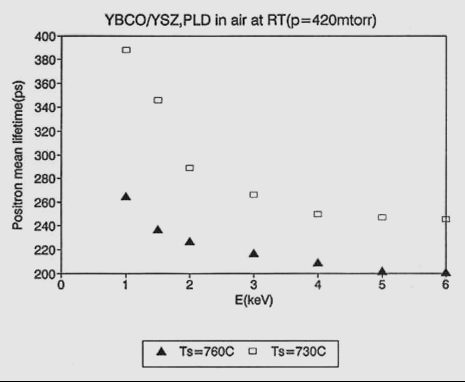
=
相同衬底温度,空气分压越高,正电子平均寿命越大
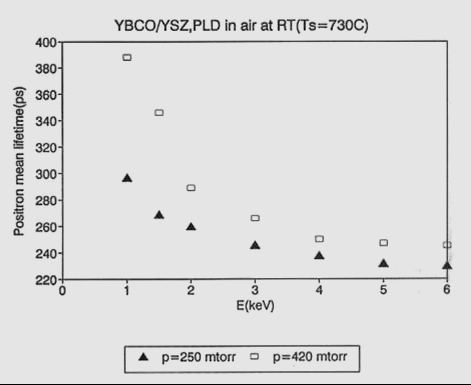
=
空位型缺陷的正电子寿命(360ps)不变

=
结论
u
空位型缺陷的类型与沉积条件无关
u
相同空气分压,衬底温度越高,缺陷越少;相同衬底温度,空气分压越高,缺陷越多
u
空位型缺陷对应的是阳离子空位及其复合体
n
正电子寿命的温度依赖关系
=
平均寿命随温度的降低而降低

=
I2 随温度的降低而降低
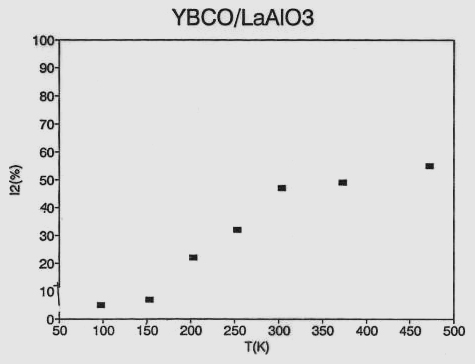
=
Tau2随着温度的降低而升高

=
(块材)平均寿命随温度的降低而升高
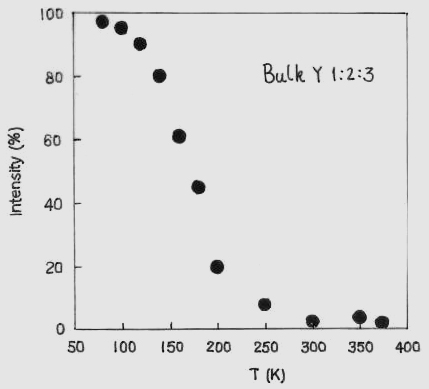
=
(块材)Tau2 与和掺杂量温度无关

=
Summary
u
深浅捕获中心共存
u
深捕获中心(缺陷)在低温下有长大的趋势,可能形成心的磁通钉扎中心
n
结论
=
高温超导薄膜中存在两类缺陷
u
浅捕获中心――位错、孪生晶界等
u
深捕获中心――阳离子空位及其复合体
=
阳离子空位及其复合体的尺度与沉积条件无关
=
低温下,缺陷有长大的趋势
正电子谱学应用之二
分子束外延硅薄膜的质量评价
分子束外延生长半导体薄膜
衬底温度的重要性―最佳生长温度LT―MBE
慢正电子束技术―无损检测外延膜质量
n
实验结果
|
样品号
|
1080
|
1079
|
1087
|
1086
|
1003
|
1078
|
|
外延层厚(nm)
|
920
|
920
|
670
|
680
|
740
|
1130
|
|
生长温度(℃)
|
RT
|
400
|
475
|
525
|
575
|
700
|
|
Sd/Sb
|
1.136
|
1.107
|
1.023
|
1.022
|
1.003
|
1.002
|
|
Sd/Sb
|
空位型缺陷类型
|
|
1.02~1.03
|
单空位
|
|
1.03~1.04
|
双空位
|
|
>1.5
|
大的空位或空位团
|
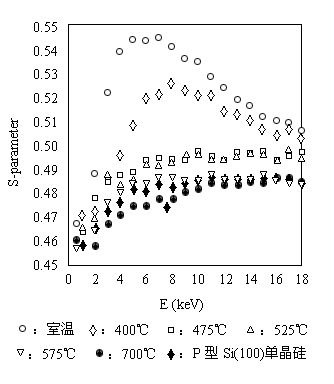
不同生长温度下分子束外延样品S参数
X Y Zhou et al, Materials Science Forum 363-365 (2001), 475 ;
n
结论 生长温度与薄膜质量
|
室温
|
|
小空位团
|
|
500℃左右
|
|
单空位
|
|
575℃
|
|
空位型缺陷基本消失
|
|
700℃
|
|
锑扩散的影响
|
正电子谱学应用之三
离子注入硅产生的缺陷及其退火行为
注入及退火条件
|
|
E(keV)
|
I(μA)
|
D(ions/cm2)
|
t2(min)
|
|
P+
|
90
|
0.5
|
2×1014
|
20
|
|
P2+
|
180
|
0.25
|
1×1014
|
20
|
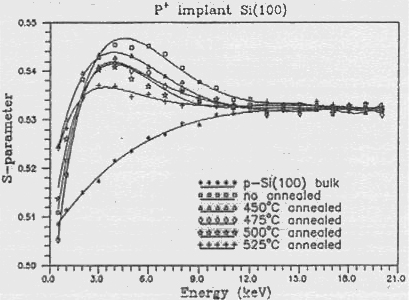
P+注入样品的实验S参数
P+注入硅引起的缺陷及其退火行为
|
退火温度
|
未退火
|
450(℃)
|
475(℃)
|
500(℃)
|
525(℃)
|
|
x1(nm)
|
94.3
|
87.4
|
74.8
|
69.2
|
63.7
|
|
x2(nm)
|
250.1
|
240.1
|
200.7
|
194.7
|
186.8
|
|
Sd/Sb
|
1.026
|
1.019
|
1.022
|
1.017
|
1.008
|
|
K(λb)
|
32
|
28
|
26
|
25
|
23
|
|
Δx(nm)
|
155.8
|
152.7
|
125.9
|
125.5
|
123.1
|
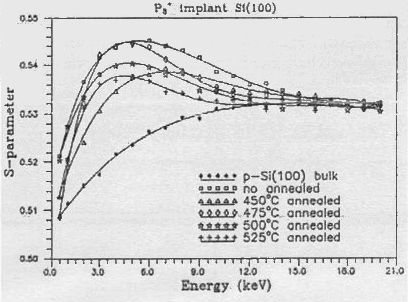
P2+注入样品的实验S参数
P2+注入硅引起的缺陷及其退火行为
|
退火温度
|
未退火
|
450(℃)
|
475(℃)
|
500(℃)
|
525(℃)
|
|
x1(nm)
|
71.3
|
67.5
|
77.1
|
64.8
|
57.4
|
|
x2(nm)
|
248.1
|
234.1
|
201.7
|
214.8
|
201.0
|
|
Sd/Sb
|
1.025
|
1.020
|
1.022
|
1.031
|
1.011
|
|
K(λb)
|
34
|
27
|
30
|
27
|
24
|
|
Δx(nm)
|
176.8
|
166.6
|
124.6
|
150.0
|
143.0
|
n
结论(方势阱拟合)
=
注入引起的缺陷类型
=
损伤区域随退火温度增加而变窄;即前沿、后沿均向注入面移动
=
退火不改变缺陷类型,只引起缺陷浓度的变化
=
P分子离子注入的缺陷层厚一些
正电子谱学应用之四
界面微结构变化的慢正电子研究
n
描述界面的模型

S
= FSSS+FOSO+FISI+FBSB
FS+FO+FI+FB
= 1
n
界面的五种物理模型
=
均匀介质模型:块材衬底
=
理想线形接触模型
=
线形全吸收模型
=
有限厚度全吸收模型
=
有限厚度模型
n
Al/GaAs
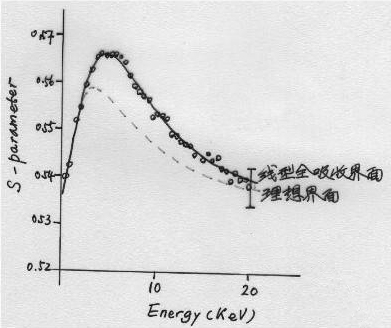
n
Au/GaAs
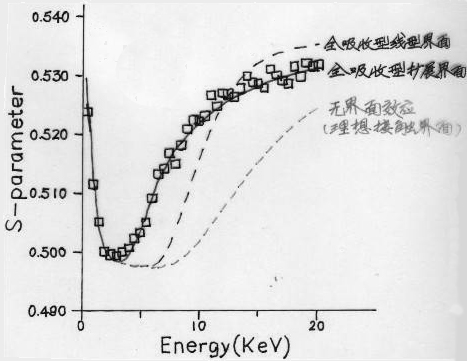
n
Al/GaAs 的退火效应